然而,根据台积电近日在北美论坛上发布的3D封装技术来看,进入3D封装后,不同的芯片能轻松实现垂直堆叠,进而再次缩小产品的整体体积 ——
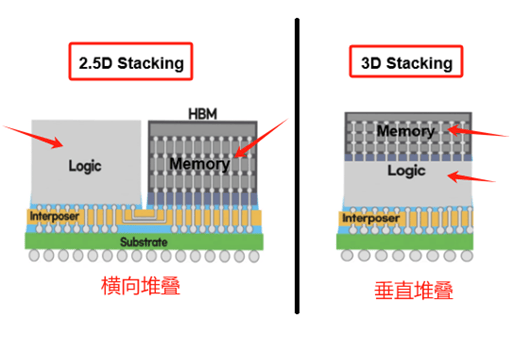
值得注意的是,该技术目前仍然在开发阶段,花旗预测会在2027年迎来爆发。作为先进封装未来的趋势,3D封装中新增的「混合键合」技术,将为半导体设备厂商(键合机厂商等)、存储供应商与晶圆代工厂商带来新的机遇。
混合键合(Hybrid Bonding)是一种实现不同芯片之间互相连接的技术。
这种技术结合了金属键合和介电键合,允许在没用传统焊料凸点的情况下,直接连接晶圆或芯片,使得芯片间距从传统的 100 微米降低到 5 微米。同时,实现了不同芯片的垂直堆叠。
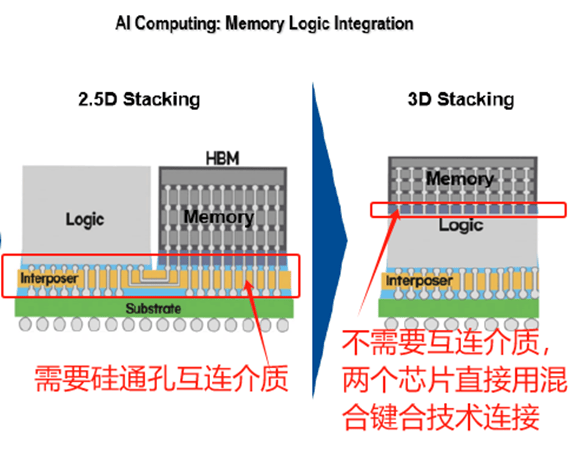
「混合键合」的工艺流程主要是三个步骤:芯片接触面的抛光、晶圆的对齐以及加温结合。

由于工艺的增加,半导体设备厂商、存储供应商与晶圆代工厂商将迎来新的机遇:

以美国为例,报告预测,到2030 年,数据中心电力需求预测将翻一番以上,新增 47 GW的电力需求,并以 15% 的复合年增长率 (CAGR) 增长。
到2030年,数据中心将占美国总电力需求的 8%,高于目前的 3%。根据测算,到2030年,美国大约要增加 47GW的电力装机。
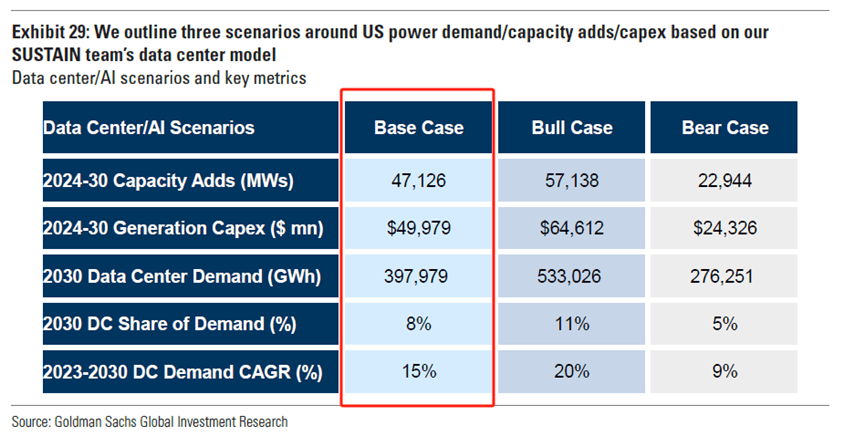
电力需求的大幅度增长,意味着电力生产和传输基础设施方面的巨额投资,为整个电力供应链的公司带来机遇,包括发电和配电制造产品的基础设施承包商和工业公司、公用事业公司等。
值得注意的是,随着芯片工艺的不断迭代,单个模型训练的电力需求也在急速下降。
今年三月的GTC大会上,NVDA CEO黄仁勋透露,GB200训练一个GPT-4(1.8万亿参数)所需的资源,从15 兆瓦电力降低到4 兆瓦电力,能耗下降了四分之三。
近期各大科技咨询公司和AI产业链的头部厂商发布的多个方面数据显示,2024年AI服务器将持续放量,同时,今年也将是AI PC放量的元年,特别是昨天微软发布了基于ARM架构的新AI PC
近期各大咨询公司,以及AI供应链上的龙头厂商发布的数据分析来看,AI服务器下半年将继续放量:
微软的 Microsoft Build 发布会,将于北京时间22日零点开始,会议持续3天。
根据公司披露的会议议程,AI PC将会是大会的重点之一,预计这次会议将又一次把AI PC推向焦点。
聚焦全球高科技产业的咨询公司Sigmaintell预测,2024年将是AIPC出货的元年,出货量约为1300万台。
预计2024年下半年,随着AI PC市场将迎来迅速增加和扩张,其产业链上的企业将受益。返回搜狐,查看更加多